Showcases
事例
概要
背景・目的
三次元集積回路の微細化の要求に対応すべく、直径10㎛の微細TSVの加工技術を構築し、その技術を用いて作製した微細TSVに適用する絶縁膜の電気的特性を評価を行った。
設計・構造
| 項目 | スペック |
|---|---|
| TSV直径 | 10㎛ |
| TSV深さ | 55㎛ |
| 絶縁膜水準 | ・熱酸化膜 ・P-CVD膜 (成膜温度:120℃,150℃,180℃) |
| 絶縁膜厚み | 0.5㎛ |
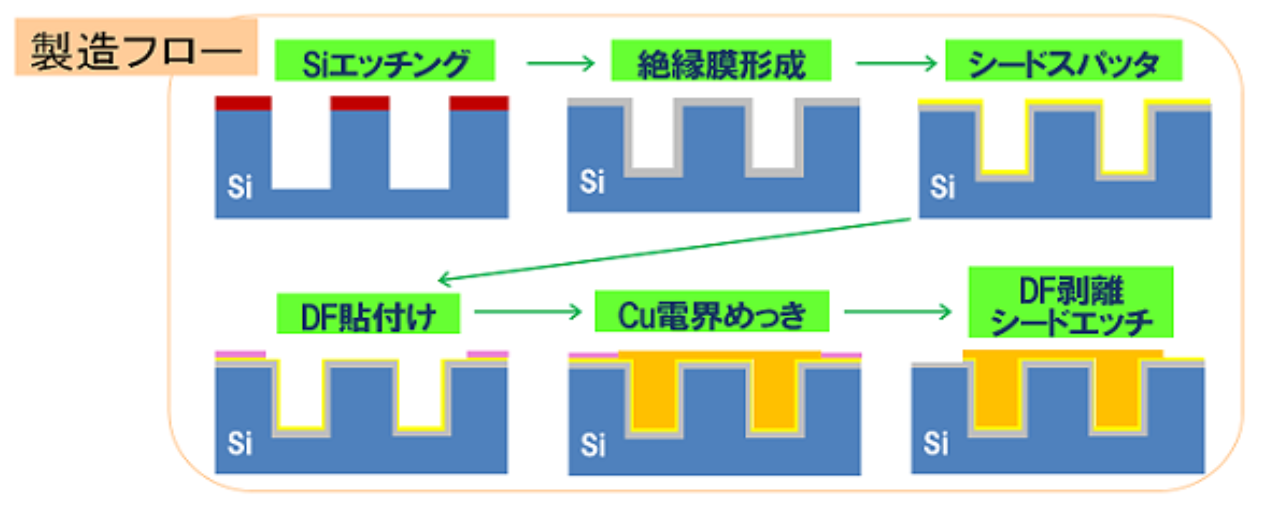
I-V測定方法と結果
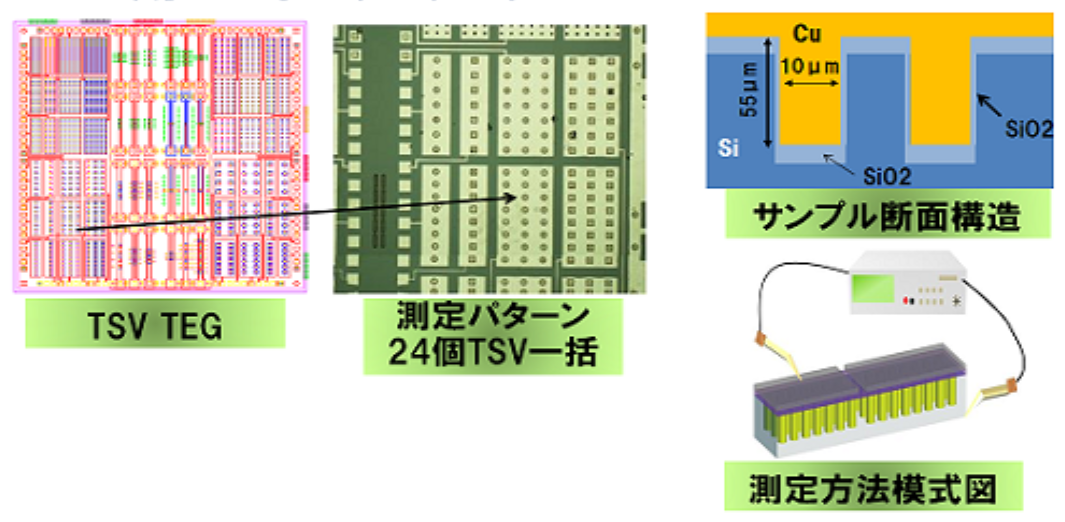
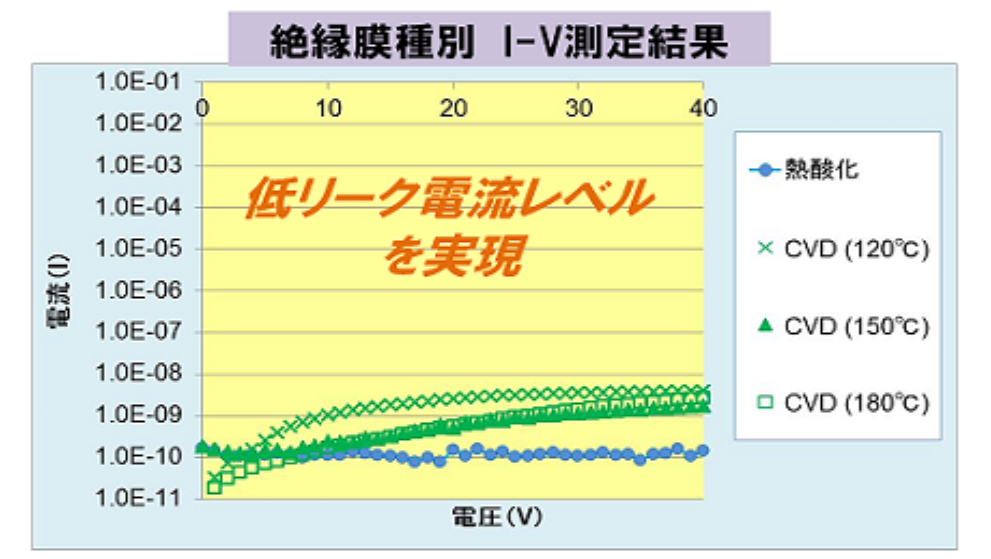
恒温恒湿試験評価
評価結果
成膜温度条件が120℃のCVD膜は恒温恒湿試験後にリーク電流のバラツキが増大する
150℃以上の成膜条件では、熱酸化と同様に試験前後で変化無く、安定した絶縁特性を示す
恒温恒湿試験条件
- 吸湿条件
JEDEC LEVEL1
(85℃/ 85%/ 168hour) - 耐熱試験
240℃リフロー×3回
I-V測定条件
TSV-Si間リーク電流測定
印加電圧: 0V~40V