Showcases
事例
概要
背景・目的
Siインターポーザ向けの微細配線形成方法の検討/評価も行っている。
- L/S=2/2から10/10㎛のくしば配線を持つTEG
- 絶縁材料:シリコン酸化膜(熱酸化/CVD)
- セミディティプロセス
- メタル2層構造
問題点
- 途中工程で発生するパターン剥離
- Biased HAST試験後の配線剥離
下地絶縁材とスパッタ膜との密着性評価が必要

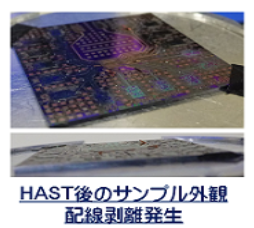
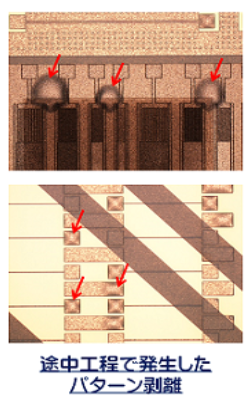
サンプル作製と評価方法
評価散サンプル作製フロー
- 下地絶縁膜形成
- ロングスロースバッタ
(シードメタル形成) - 電解銅めっき
銅厚:20㎛ - DFラミネート/露光/l現像
- Cuエッチング(サフトラ)
- DF剥離
- Tiエッチング
- ダイシング
- アニール(必要に応じて)
- 90゜ピール試験
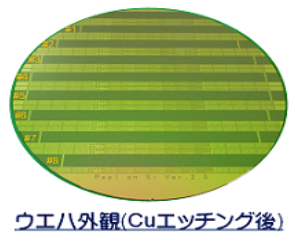
- サンプル幅:20mm
- ダミーバターン:剥離評価用
- サイズ:1,0.5, 0.4, 0.3,0.2, 0.1,0.08,0.05mm
- ピール幅:10mm
- 16回測定可(1ウエハあたり)


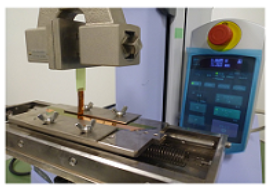
試験条件
- 90ピール試験
- 試験速度:50mm/min
- 試験長さ:50mm
- 試験幅:10mm
- ロードセル: 100N(Max.)
評価結果
スパッタシードメタル
- Ti/Cu
- TiN/Ti/Cu
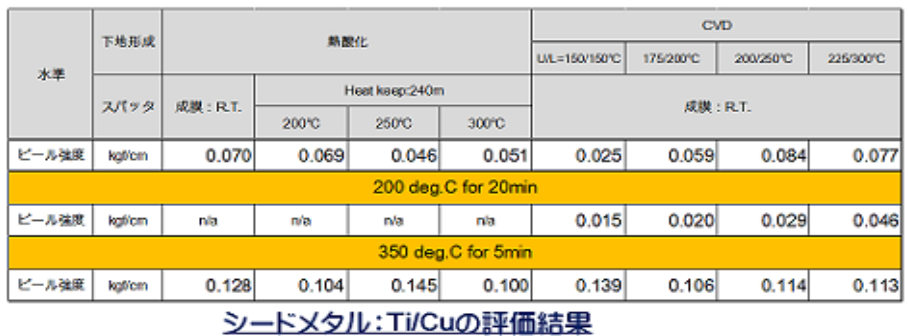
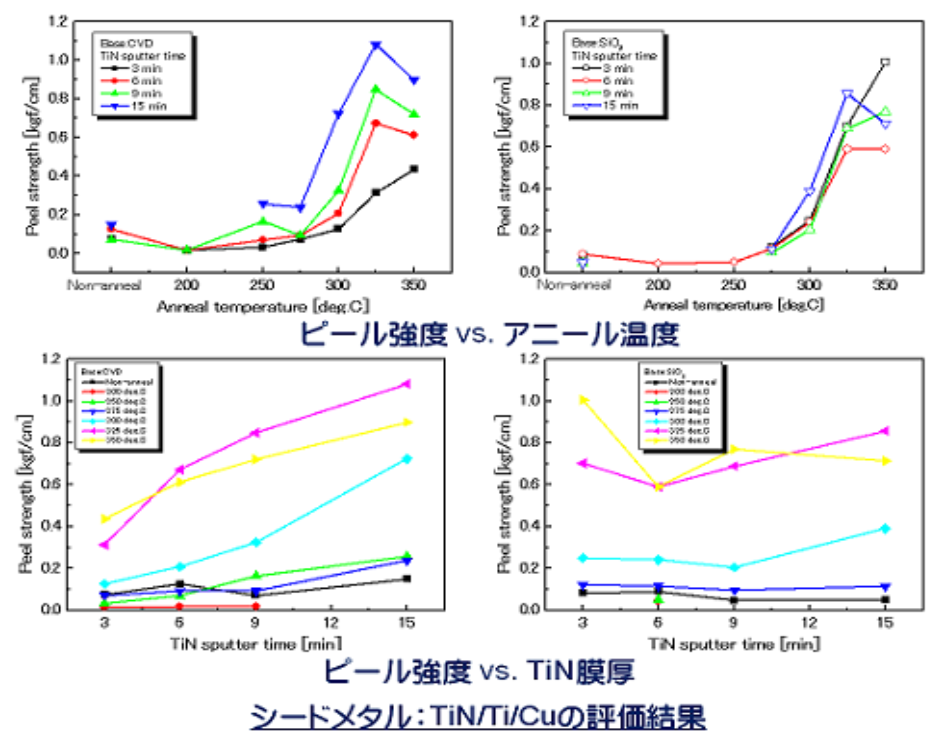
まとめと今後の課題
Ti/Cuシード
- 350℃のアニールで密着性が若干上昇したが、0.1kgf/cmと低密着
TiN/Ti/Cuシード
- 325℃以上のアニール+TiN成膜9min以上で0.6kgf/cmの高い密着性
- 暫定条件…Ti N成膜9min + 350℃-20min
今後の評価事項
- HAST評価サンブルの作製工程ヘアニールブロセスを適応
- シリコン酸化膜で作製したSl0601/0602の絶縁信頼性評価
- その他の材料とスパッタ膜の密着性評価