Technology Database
技術データベース
CMP均一研磨
概要
背景・目的
- CMP工程おいて銅の削れ方が面内で違う為に、銅を完全にとるまでにCMPをかけている時間が長くなってしまう
- 時間がかかることによって、銅がすでになくなっている箇所のディッシングが加速してしまう
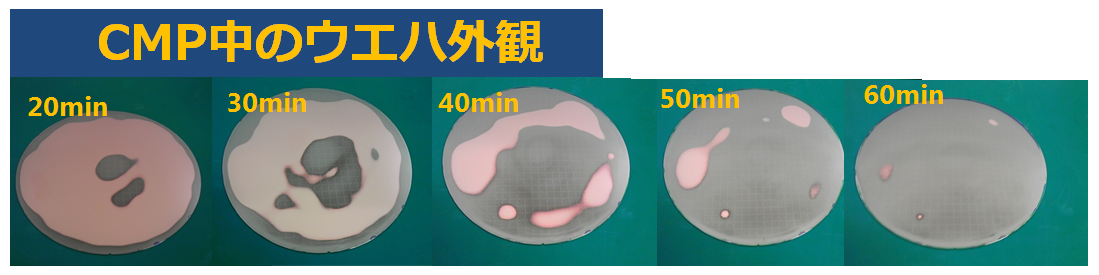
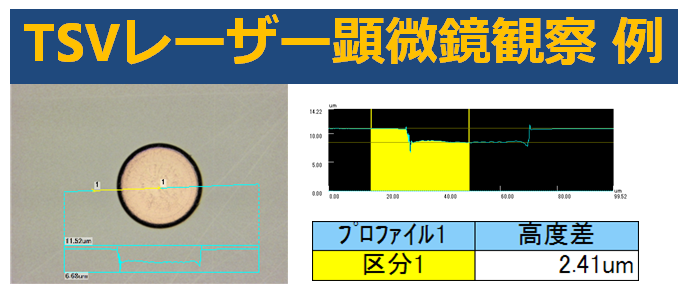
- 先にSi面までCMPが完了している箇所は30分以上もかかり続けている
- CMPが長くかかってしまった箇所のTSVはSi面より2um以上Cu面が下がっていいる。CuCMPの均一研磨が必要である
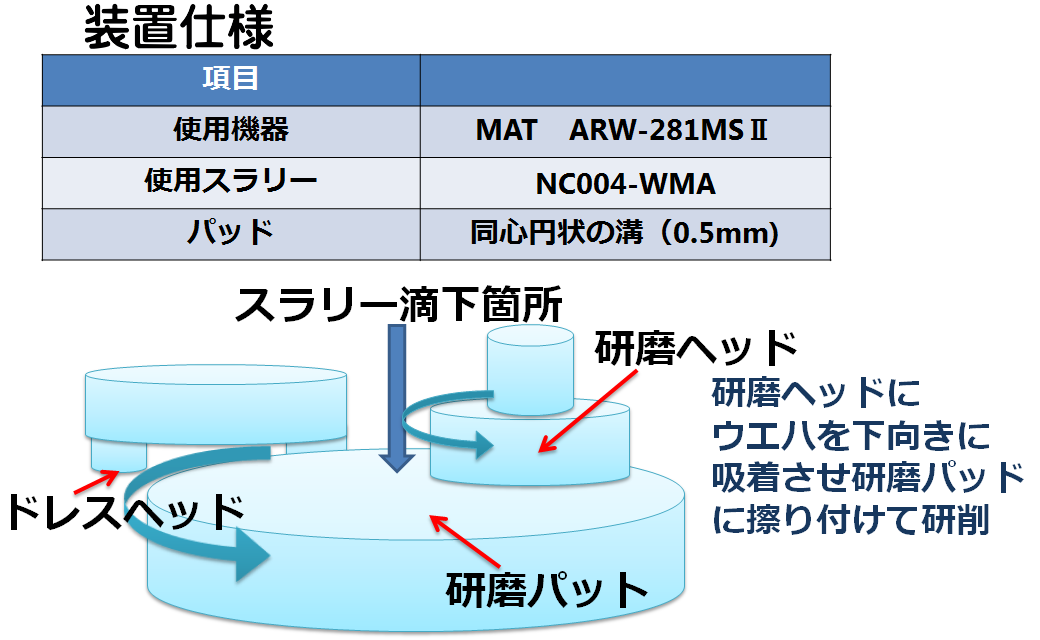
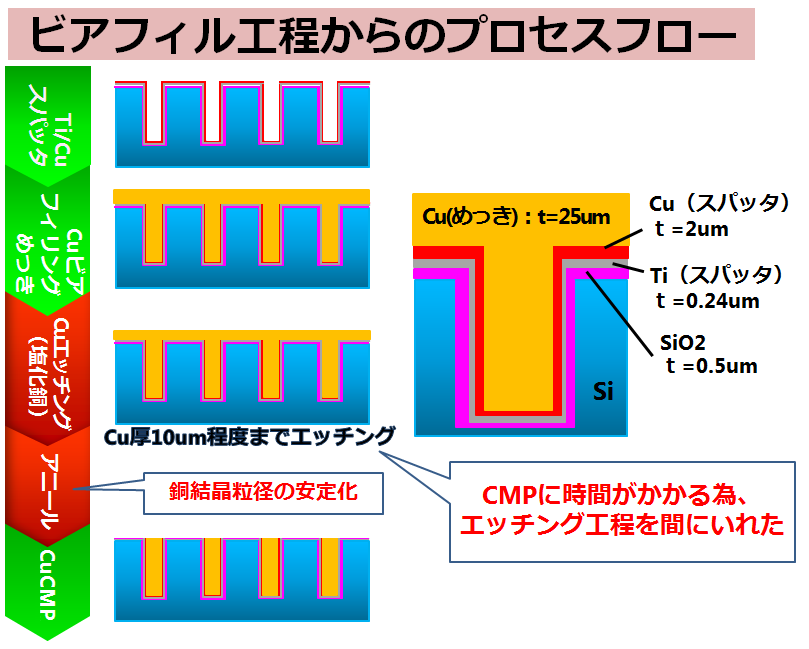
プロセスポイント
- インラインドレス
ドレスはCMPの研磨前に使用していたが、CMP研磨中にドレスをかけることによりパッドの状態を常に良好な状態でCMPを行うように変更
インラインドレス使用時はスラリー滴下位置を最適位置に変更
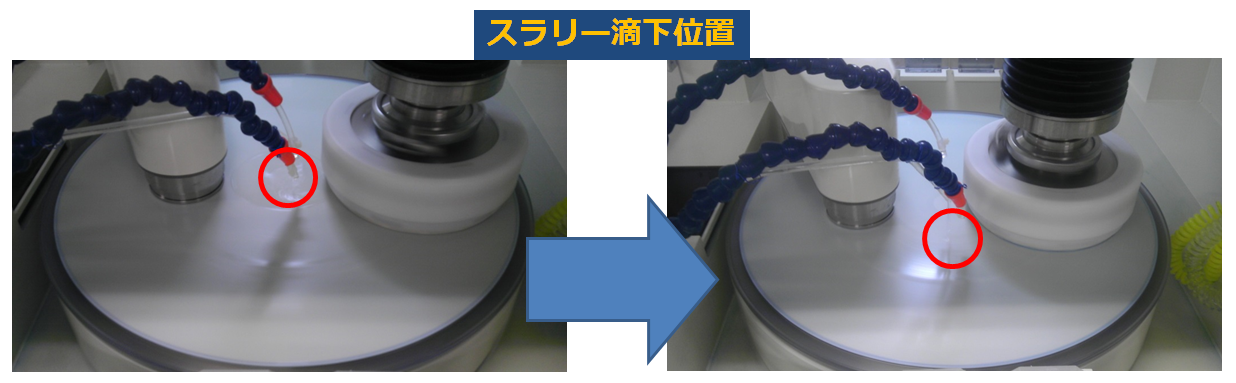
- ドレスレシピ改善によりパッド形状

- 研磨パッド溝形状の変更

プロセス改善後の比較
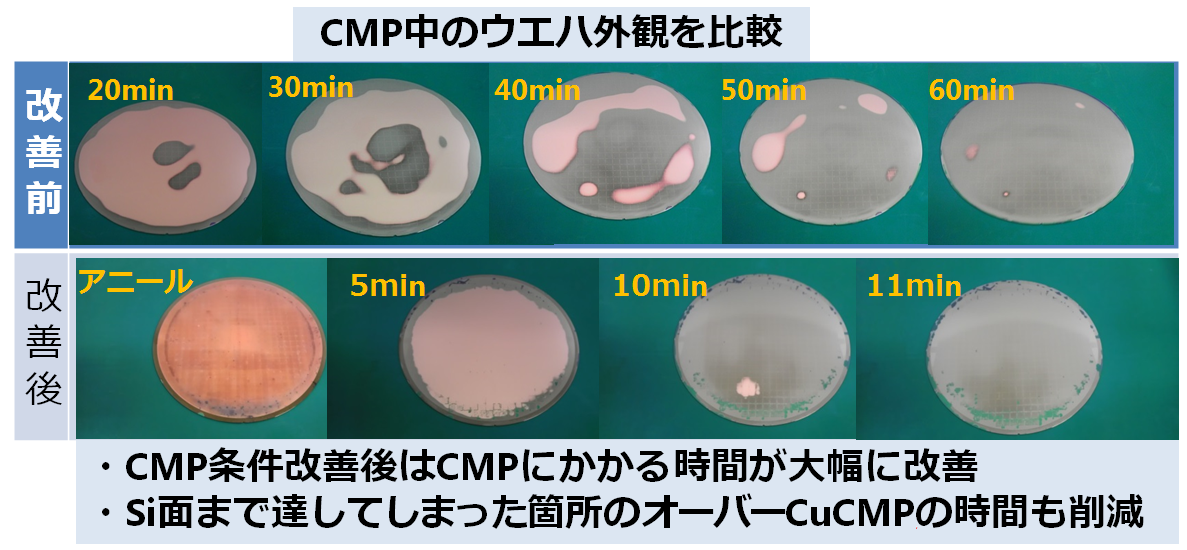
- CMP条件改善前はウエハの外側がより多くCMPがかかってしまう傾向があったが、改善後は面内の状態が均一化された