Technology Database
技術データベース
固相拡散接合を用いたフリップチップ接合
概要
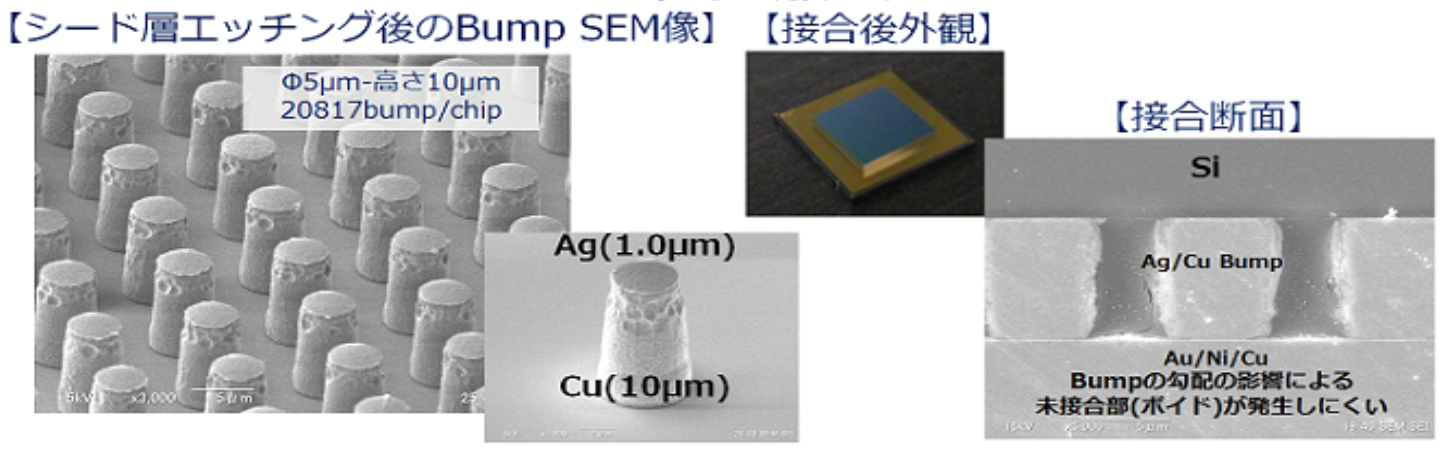
シリコン・ガラスインターポーザーを用いた2.5D実装およびTSVを用いた3D高集積パッケージではバンプの微細化・ファインピッチ化が予測され、フリップチップ実装時のマイクロ接合では従来のはんだ等のバンプ材料だけでなく熱拡散を利用した銅、Auなどの直接接合も評価されている。福岡大学実装研究所・三次元半導体研究センターで評価を進めている部品内蔵用チップの電極形成技術を利用して作成した2.5/3D高集積パッケージに向けた超微細バンプ形成手法と固相拡散接合を用いたフリップチップ接合を紹介する。
マイクロバンプ形成・インターポーザー製造
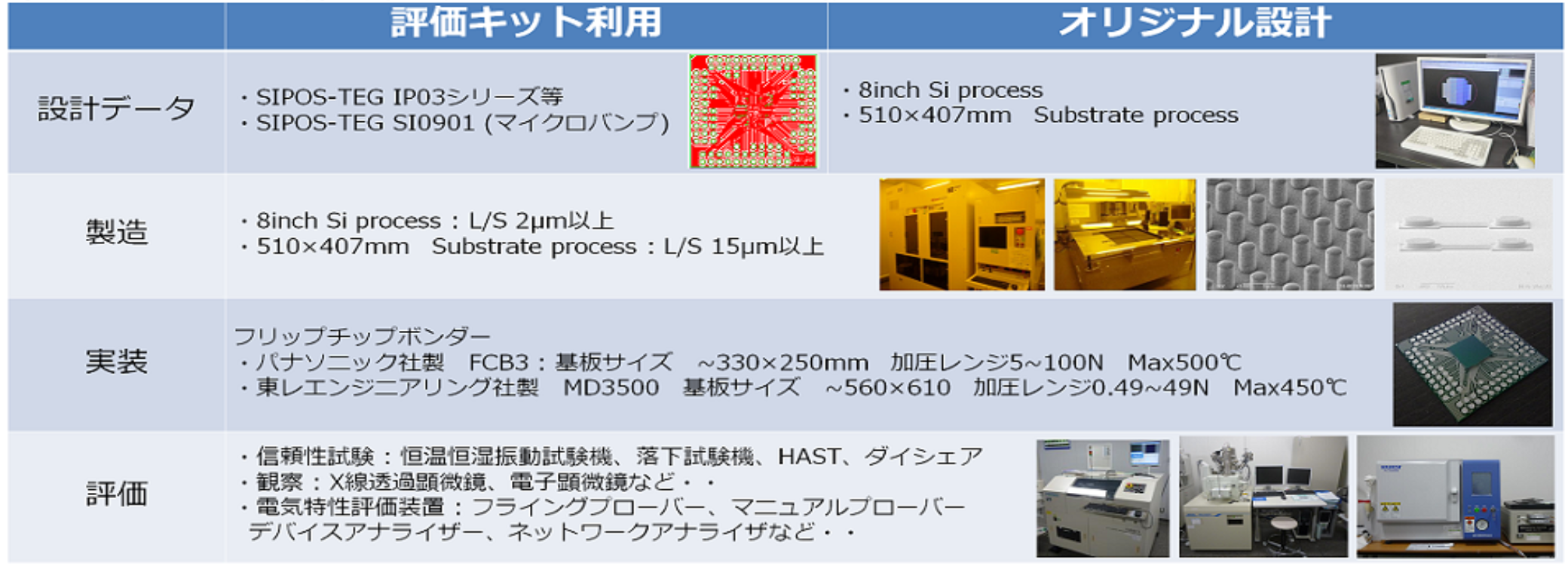
Agバンプ固相拡散接合
メリット
- ファインピッチボンディング
- ボンディング後洗浄不要
- 大気中ボンディング
デメリット
- 高圧力によるダメージ
- Bump、Padの高平坦性
- セルフアライメント無し
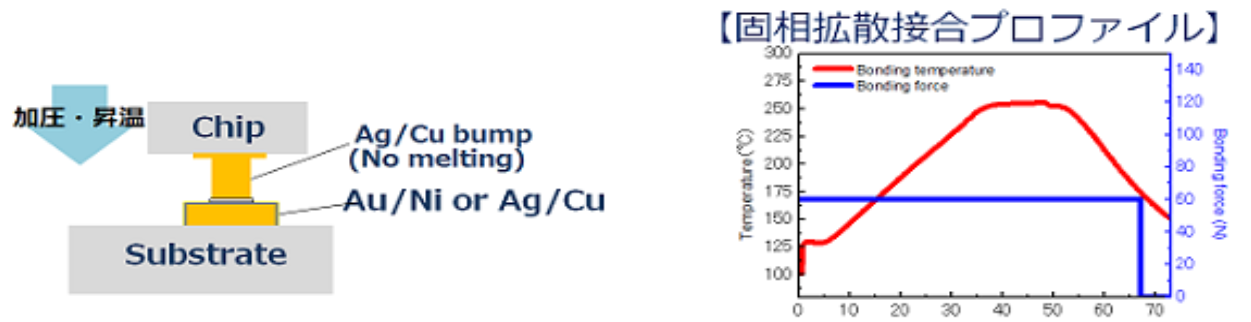
SIPOS-TEG IP03評価キット Ag/Cuバンプを使用した拡徹接合例
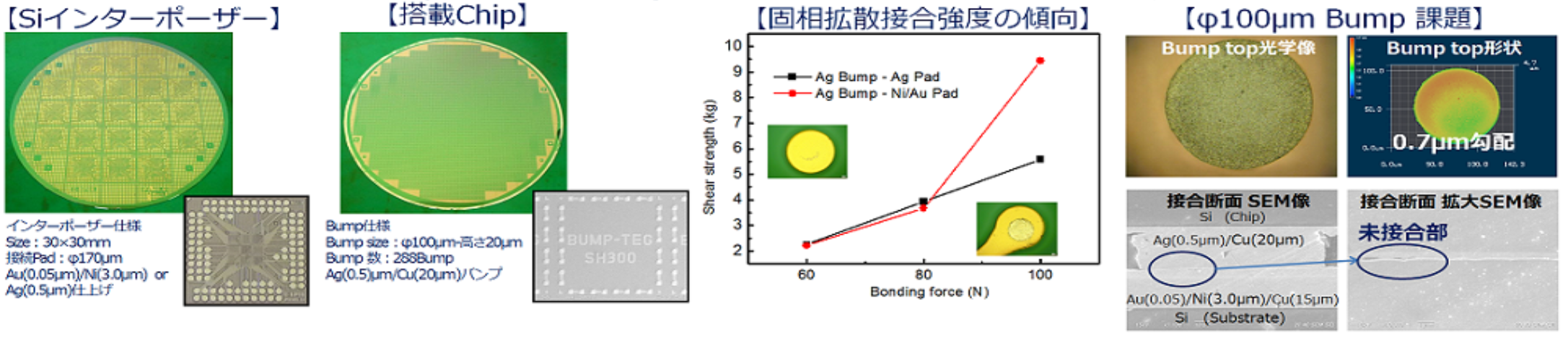
Ultra fine micro bump 拡散接合
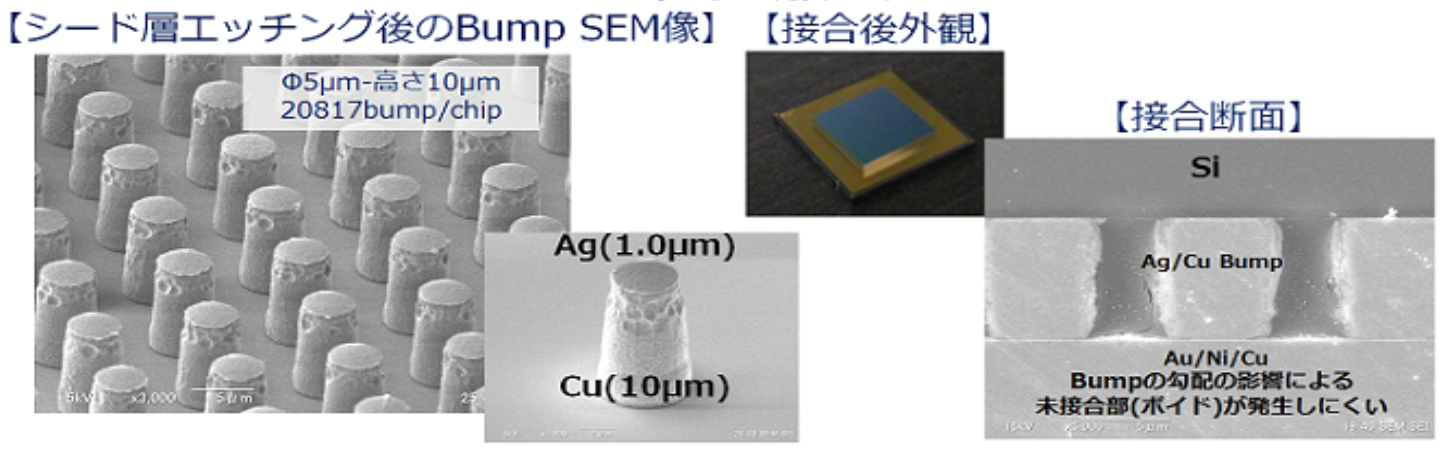
今後の取組
- 接合温度の低温化
- 接合圧力の低圧化
- デイジーチェーン構造の製造
- 信頼性試験、電気特性評価



